Mikroskopielabor
Folgende Ausstattungen unterstützen uns bei der Forschungsarbeit:
-
Integrated Laserscanning Mikroskop: Keyence VK-X3000
-
Konfokales Weißlichtmikroskop: NanoFocus µsurf
-
Faserlaser: Metaquip Desktop Lite
-
Konfokaler achromatischer Wegmesssensor: Keyence CL-3000
-
Modifiziertes Rasterelektronenmikroskop (REM): Zeiss DSM 940A
-
Rasterkraftmikroskop (AFM): SIS UltraObjective
-
Weißlichtinterferometer: Veeco Wyko NT1100
Integrated Laserscanning Mikroskop (Keyence VK-X3000)
Messverfahren:
- Fokusvariation
- Z-Auflösung: 0,1nm
- Konfokales Laserscanning
- Z-Auflösung: 0,1nm
- Weißlichtinterferometrie
- Z-Auflösung: 0,01nm
Technische Daten:
- Optisches 3D-Messgerät
- CMOS-Farbkamera
- Lateraler Messbereich: 100x100mm (Motorisierter Objekttisch VK-D3)
- Vertikaler Messbereich: 7mm (Piezoantrieb)
- Aktive Schwingungsisolation (Accurion I4)
Anwendungsgebiete:
- Messung der Oberflächentopographien
- Charakterisierung der Oberflächenrauheit



Faserlaser (Metaquip Desktop Lite)
Technische Daten:
- Laserquelle: Faserlaser
- Laserleistung: 30W
- Wellenlänge: 1064nm
- Laserklasse: Klasse 1
- Arbeitsfläche: 100mmx100mm
- Absaugung: Hepafilter
Anwendungsgebiete:
Mikromaterialbearbeitung
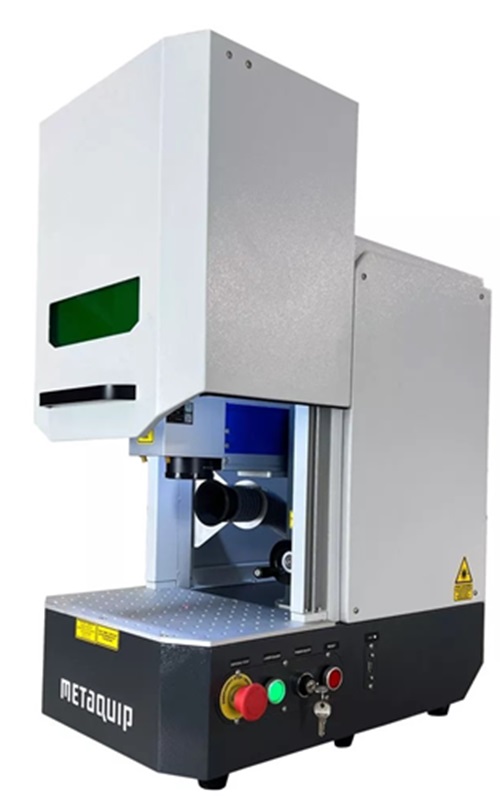
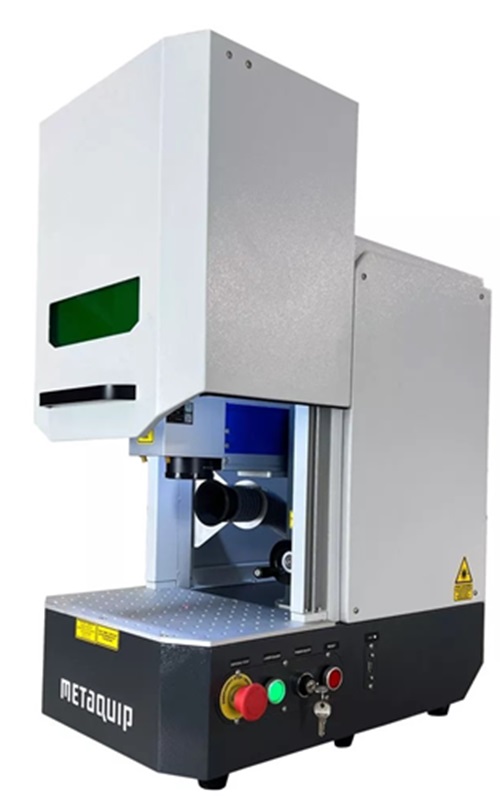
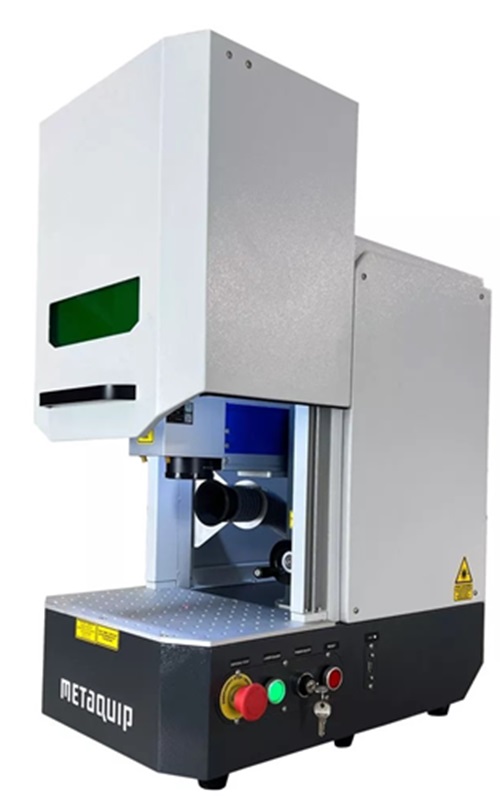
Konfokaler achromatischer Wegmesssensor (Keyence CL-3000)
Technische Daten:
- Messkopf: CL-S015
- Lichtpunktdurchmesser: ø10 µm
- Referenzabstand: 15 mm
- Messbereich: ±1 mm
- Auflösung: 0,25 μm
Anwendungsgebiete:
- Sichtdickenmessung



Konfokales Weißlichtmikroskop (NanoFocus µsurf)
Technische Daten:
- Optisch 3D-Messgerät
- Lichtquelle: 100W Xenon Kaltlichtquelle
- CCD-Kamera: 1024x1024 Pixel
- Lateraler Messbereich: 100x100mm (Schrittmotor)
- Vertikaler Messbereich: 350µm (Piezoantrieb)
- Optikmodule
- Objektiv: 10x / 20x / 50x / 100x
- Numerische Apertur: 0.3 / 0.46 / 0.8 / 0.95
- Messfeld: 1600x1600µm / 800x800µm / 320x320µm / 160x160µm
- Arbeisabstand: 10.1mm / 3.1mm / 0.66mm / 0.31mm
- max. Steigungswinkel: 8.7° / 13.7° / 26.6° / 35.9°
- Vertikale Auflösung: 20nm / 5nm / 2nm / 1nm
Anwendungsgebiete:
- Messung der Oberflächentopographien
- Charakterisierung der Oberflächenrauheit
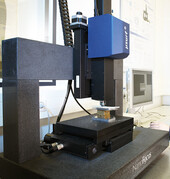
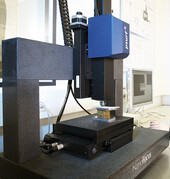
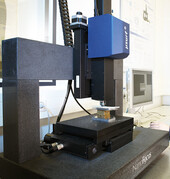
Modifiziertes Rasterelektronenmikroskop (REM) Zeiss DSM 940A
Konzept:
-
Messsystem zur Anwendung der am imr entwickelten dreidimensionalen Rekonstruktionsmethode für REM Aufnahmen
-
Ausstattung der Probenkammer mit insgesamt vier Sekundärelektronendetektoren
-
Modifikation des Kollektorgitters zur optimierten Elektronenregistrierung
Ziel:
- Dreidimensionale Messdatenerfassung mit einer Auflösung von ca. 50nm
- Verlässliche Rekonstruktion von Flanken mit einem Steigungswinkel von ca. 70°






Rasterkraftmikroskop (AFM) SIS UltraObjective
Allgemein:
Das AFM der Firma SIS lässt sich im kontaktlosen Modus und im Kontaktmodus betreiben und ist in einem Zeiss Mikroskop integriert, das sich sowohl als normales Lichtmikroskop als auch als Phasenkontrast und Dunkelfeldmikroskop betreiben lässt.
Technische Daten:
- Messfeldgröße: 300 µm x 300 µm
- Vertikaler Messbereich. 20 µm
- Vertikale Auflösung: bis 0.1 nm
- Lateriale Auflösung: bis wenige Nanometer (abhängig von Tastspitze)
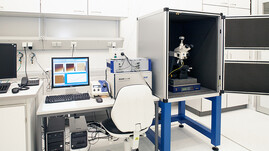
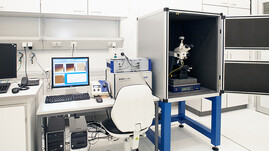
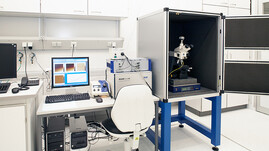



Weißlichtinterferometer Veeco Wyko NT1100
Technische Daten:
- Typ: Weißlichtinterferometer
- Hersteller: Veeco
- Modell: Wyko NT1100
- Messprinzip: Coherence Scanning Interferometry (CSI) mit Optionen für Vertical Scanning Interferometry (VSI) und Phase Scanning Interferometry (PSI)
- Lichtquelle: Weißlichtquelle mit geringer Koheränzlänge
- Kameratyp: CCD
- Messbereiche:
- Lateral (XY): 100mm x 100mm (XY-Stitching Tisch)
- Vertikal: 0,1 nm bis 1 mm
- Auflösung:
- Vertikale Auflösung: <0,1 nm
- Wiederholbarkeit (RMS): 0,01 mm
Anwendungsgebiete:
- 3D-Rekonstruktion von Oberflächen: Einsatz von Coherence Scanning Interferometry zur 3D-Rekonstruktion aus Bildstapeln.
- Besonders geeignet für die Untersuchung von Oberflächen mit hohen Reflexionseigenschaften.
- Charakterisierung von Oberflächentopographien: Analyse der Mikrostruktur der Oberfläche in hoher Auflösung.
- Oberflächenrauheit: Beurteilung der Rauheit der Oberflächenstruktur mittels detaillierter Topographieanalysen.
- Dickenmessung von dünnen Filmen: Möglichkeit zur Untersuchung der Dicke von dünnen Filmen über Phase Scanning Interferometry.